Select your region or country.
HyperGauge 膜厚测量系统
C17319-11
短短 5 秒内即可完成直径达 300 mm 晶圆的厚度分布测量
HyperGauge 膜厚测量系统 C17319-11 采用光谱干涉法进行精准的膜厚测定。采用 λ-Capture 技术,无需光谱仪即可利用高灵敏度相机检测波长偏移,短短 5 秒内即可完成直径达 300 mm 的整个晶圆的薄膜厚度测量。
面内厚度分布快照
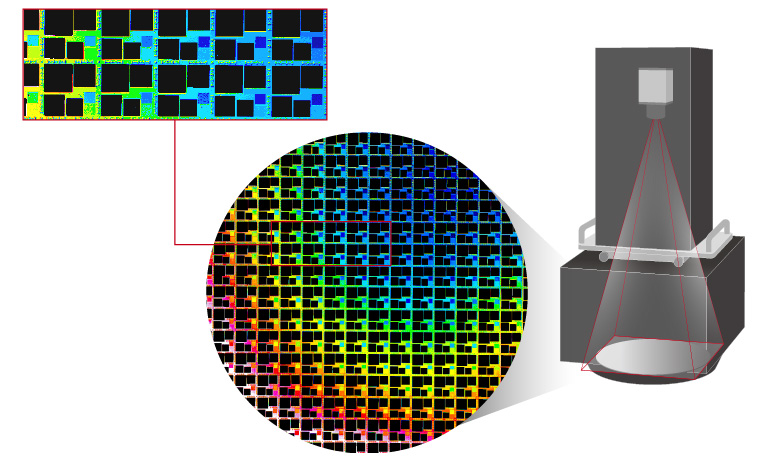
与点传感器系统相比,HyperGauge 膜厚测量系统 C17319-11 可显著提升厚度分布采集速度。该系统结合了高空间分辨率和高重复性测量,达到了检查裸晶圆和图案化晶圆所需的精度要求。
短短 5 秒即可完成厚度分布采集
该系统采用滨松专有的波长检测技术 λ-Capture,并结合高灵敏度相机,实现了基于区域的厚度测量。短短 5 秒内即可完成直径达 300 mm 晶圆的面内厚度分布采集。由于整个晶圆表面可一次性成像,与点传感器系统相比,该系统简化了测量点选择和对准流程。
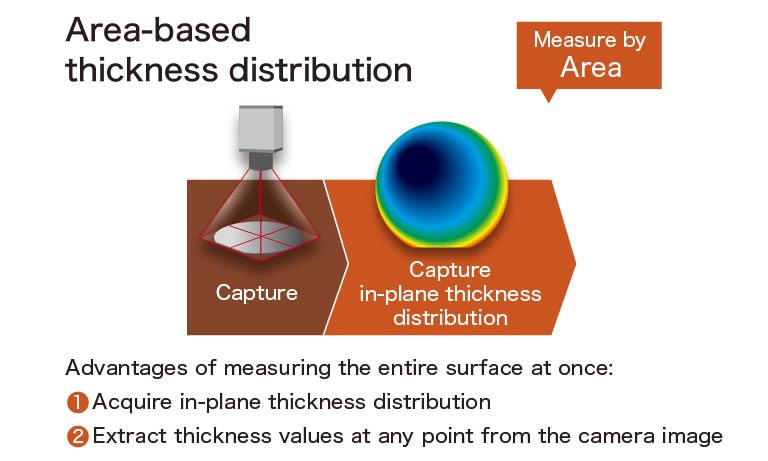
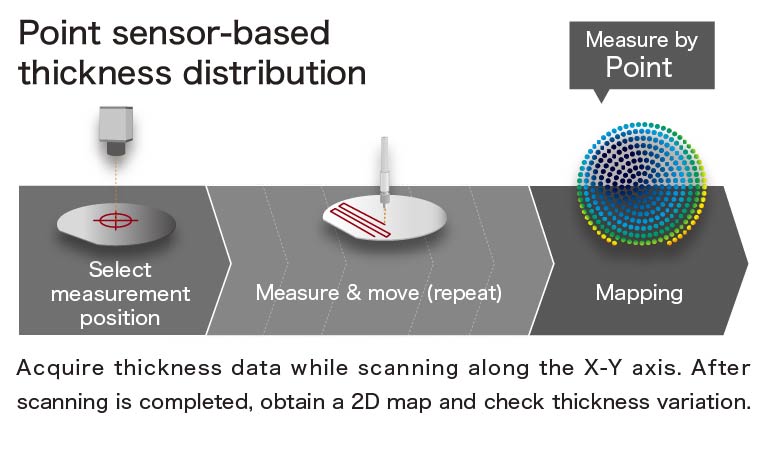
借助快速均匀性测量提高生产力
在半导体制造过程中,由于受腔室内管脚温度等因素的影响,晶圆薄膜厚度可能发生变化。这些厚度非均匀性会对产品质量产生负面影响,因此必须在各过程步骤之间实现薄膜厚度的均衡。使用点传感器系统时,受时间限制,测量点数量有限,因而难以全面获取面内厚度分布情况。通过采用基于区域的测量方法,我们的系统在短短 5 秒内即可完成从约 75 万个点对面内厚度分布的测量。这样就能缩短处理时间,从而提高生产力,并通过全面的厚度分布分析提高良品率。快速的面内均匀性测量可显著提高半导体制造的生产力和质量。
腔室所致厚度变化
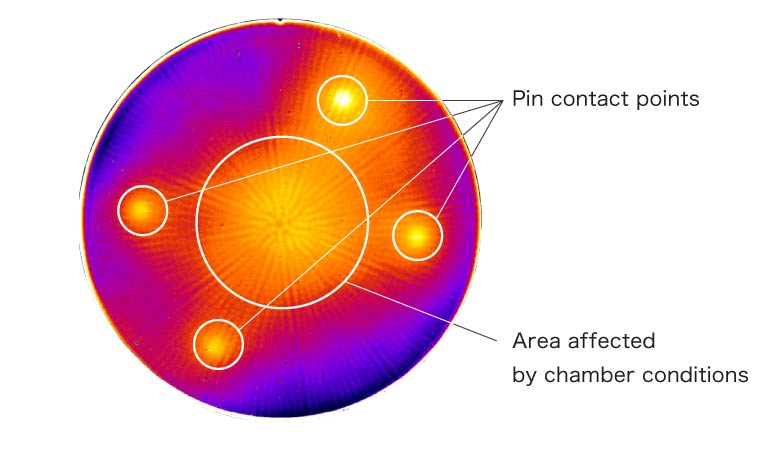
半导体制程中的厚度检查

测量示例
图样评估(厚度分布轮廓比较)
我们获取了图样间的厚度分布情况,并比较了采用点传感器法的 Optical NanoGauge 与采用基于区域法的 HyperGauge 的厚度分布轮廓。结果表明,HyperGauge 测量薄膜厚度的精度可与点传感器法相媲美。
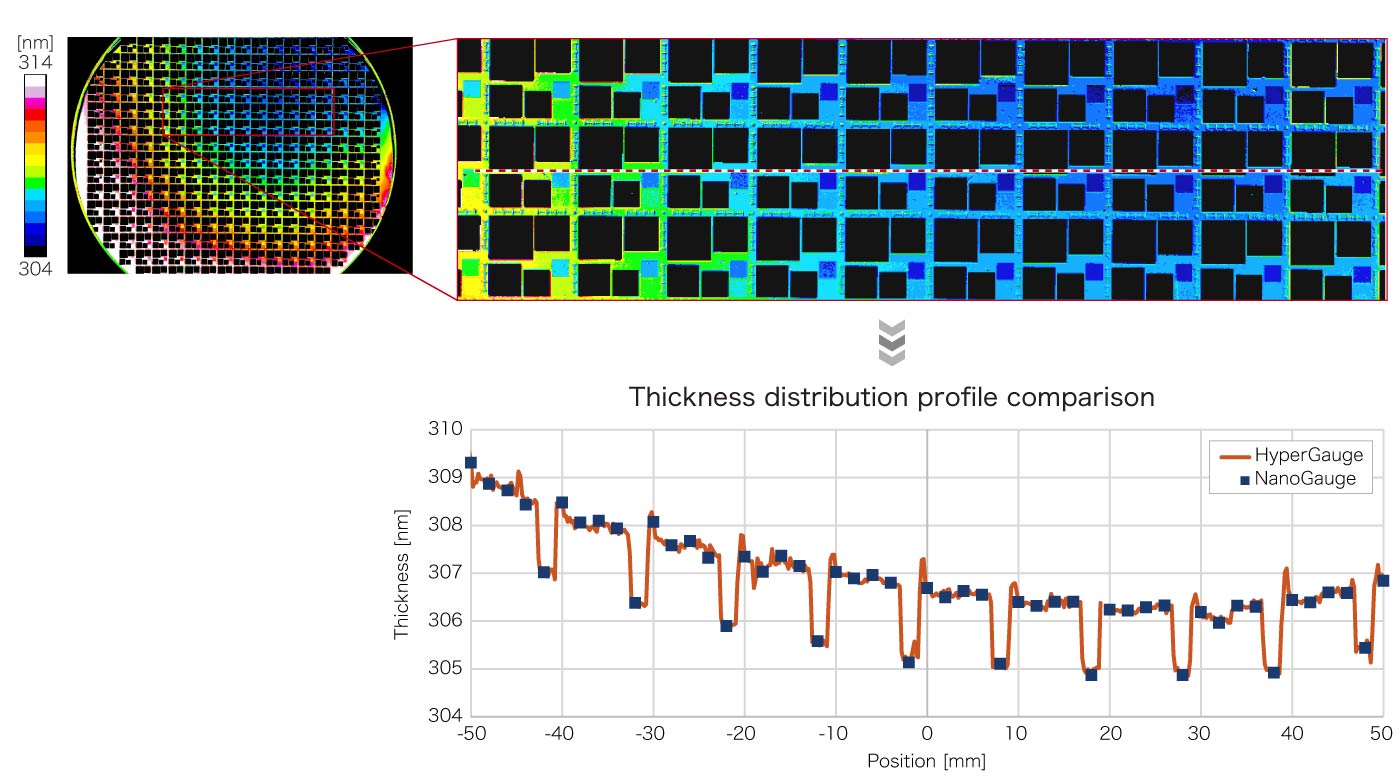
大范围非均匀性:SiO2 300 nm

小范围非均匀性:SiO2 500 nm
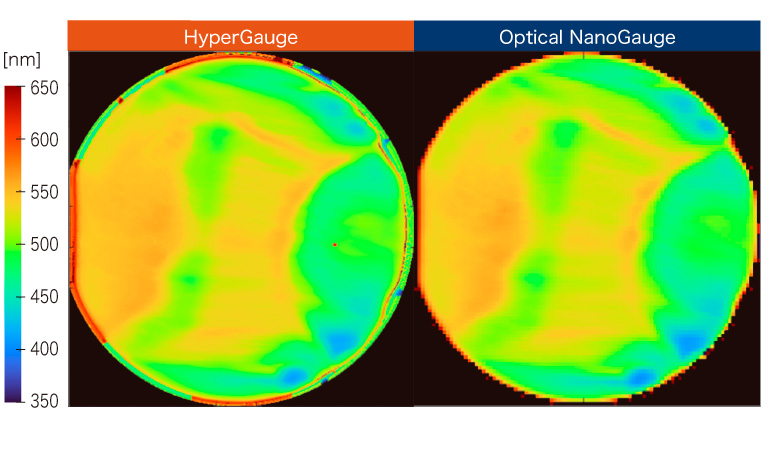
超薄薄膜:SiO2 10 nm
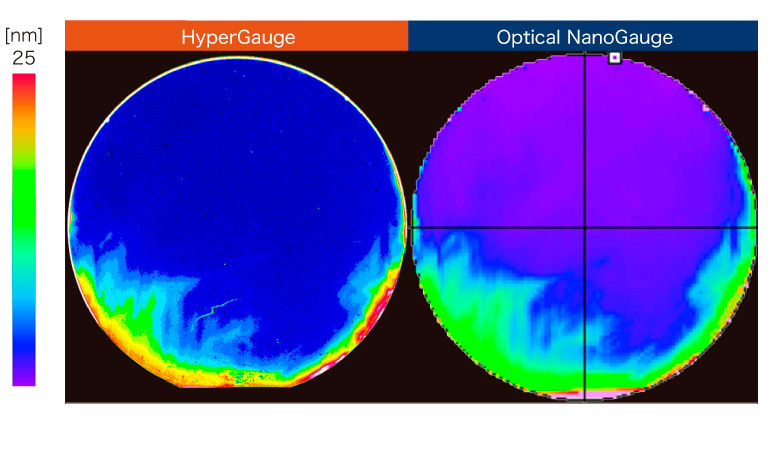
图样评估:SiOx2 300 nm
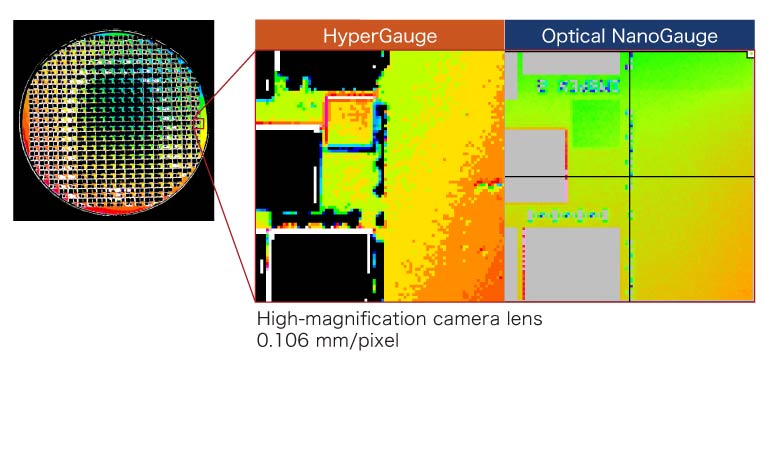
通过水和玻璃:SiO2 500 nm

测量原理
HyperGauge 采用光谱干涉法。此方法通过分析薄膜样品的反射来测量薄膜厚度。干涉光谱随薄膜厚度变化而发生偏移。

用于高速波长测量的 λ-Capture 技术
λ-Capture 是一种专有波长检测技术,无需使用光谱仪即可进行波长测量。对整个晶圆进行波长测量时,使用常规光谱仪进行点测量或使用成像光谱仪进行线测量都需要花费大量的时间。
该技术利用两台高灵敏度相机对整个区域内的波长进行测量,从而实现对整个晶圆表面的高速光谱测量。通过将这项技术整合到 HyperGauge 中,短短 5 秒内即可完成对整个晶圆的面内薄膜厚度分布测量。
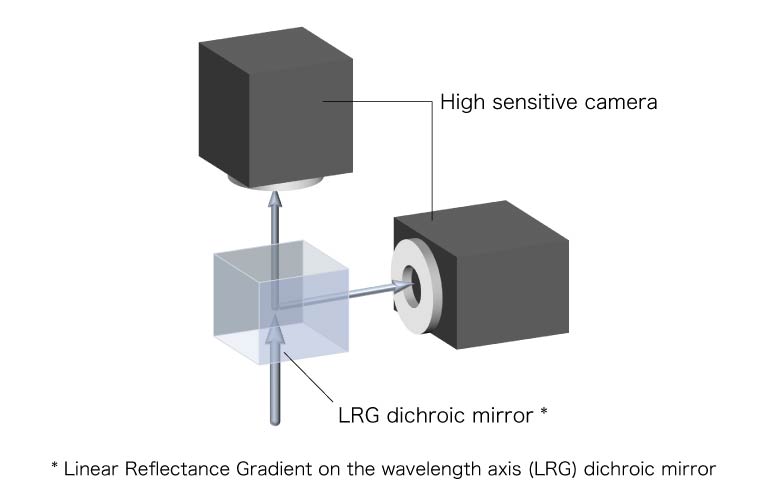
详细参数
| 产品编号 | C17319-11 |
|---|---|
| 测量薄膜厚度范围 | 10 nm 至 1000 nm |
| 测量精度 | 薄膜厚度 10 nm 至 100 nm:±1 nm 薄膜厚度 100 nm 至 1000 nm:±1% |
| 测量可再现性 | 薄膜厚度 10 nm 至 100 nm(96 次积分):0.1 nm 薄膜厚度 100 nm 至 1000 nm(96 次积分):±0.1% |
| 稳定性 | 温度依赖性:环境温度变化 +20°C 至 +30°C:±1% 高度依赖性(5 mm 高度变化):±1% 长期稳定性(启动后 1 小时):±0.5% |
| 视野 | 整个 300 mm 晶圆表面 |
| 空间分辨率 | 0.3 mm/像素 |
| 工作距离 | 场镜底部至样品表面距离:30 nm 至 100 mm |
| 分析 | λ-Capture 分析 |
| 测量时间(包括分析时间)*1 | 5 秒 |
| 外部通信接口 | Camera Link,RS-232C |
| 电源电压 | 直流 24 V |
| 用电功耗 | 大约 40 W |
*1 取决于测量和分析条件。
尺寸

- Confirmation
-
It looks like you're in the . If this is not your location, please select the correct region or country below.
You're headed to Hamamatsu Photonics website for (Chinese). If you want to view an other country's site, the optimized information will be provided by selecting options below.
In order to use this website comfortably, we use cookies. For cookie details please see our cookie policy.
- Cookie Policy
-
This website or its third-party tools use cookies, which are necessary to its functioning and required to achieve the purposes illustrated in this cookie policy. By closing the cookie warning banner, scrolling the page, clicking a link or continuing to browse otherwise, you agree to the use of cookies.
Hamamatsu uses cookies in order to enhance your experience on our website and ensure that our website functions.
You can visit this page at any time to learn more about cookies, get the most up to date information on how we use cookies and manage your cookie settings. We will not use cookies for any purpose other than the ones stated, but please note that we reserve the right to update our cookies.
1. What are cookies?
For modern websites to work according to visitor’s expectations, they need to collect certain basic information about visitors. To do this, a site will create small text files which are placed on visitor’s devices (computer or mobile) - these files are known as cookies when you access a website. Cookies are used in order to make websites function and work efficiently. Cookies are uniquely assigned to each visitor and can only be read by a web server in the domain that issued the cookie to the visitor. Cookies cannot be used to run programs or deliver viruses to a visitor’s device.
Cookies do various jobs which make the visitor’s experience of the internet much smoother and more interactive. For instance, cookies are used to remember the visitor’s preferences on sites they visit often, to remember language preference and to help navigate between pages more efficiently. Much, though not all, of the data collected is anonymous, though some of it is designed to detect browsing patterns and approximate geographical location to improve the visitor experience.
Certain type of cookies may require the data subject’s consent before storing them on the computer.
2. What are the different types of cookies?
This website uses two types of cookies:
- First party cookies. For our website, the first party cookies are controlled and maintained by Hamamatsu. No other parties have access to these cookies.
- Third party cookies. These cookies are implemented by organizations outside Hamamatsu. We do not have access to the data in these cookies, but we use these cookies to improve the overall website experience.
3. How do we use cookies?
This website uses cookies for following purposes:
- Certain cookies are necessary for our website to function. These are strictly necessary cookies and are required to enable website access, support navigation or provide relevant content. These cookies direct you to the correct region or country, and support security and ecommerce. Strictly necessary cookies also enforce your privacy preferences. Without these strictly necessary cookies, much of our website will not function.
- Analytics cookies are used to track website usage. This data enables us to improve our website usability, performance and website administration. In our analytics cookies, we do not store any personal identifying information.
- Functionality cookies. These are used to recognize you when you return to our website. This enables us to personalize our content for you, greet you by name and remember your preferences (for example, your choice of language or region).
- These cookies record your visit to our website, the pages you have visited and the links you have followed. We will use this information to make our website and the advertising displayed on it more relevant to your interests. We may also share this information with third parties for this purpose.
Cookies help us help you. Through the use of cookies, we learn what is important to our visitors and we develop and enhance website content and functionality to support your experience. Much of our website can be accessed if cookies are disabled, however certain website functions may not work. And, we believe your current and future visits will be enhanced if cookies are enabled.
4. Which cookies do we use?
There are two ways to manage cookie preferences.
- You can set your cookie preferences on your device or in your browser.
- You can set your cookie preferences at the website level.
If you don’t want to receive cookies, you can modify your browser so that it notifies you when cookies are sent to it or you can refuse cookies altogether. You can also delete cookies that have already been set.
If you wish to restrict or block web browser cookies which are set on your device then you can do this through your browser settings; the Help function within your browser should tell you how. Alternatively, you may wish to visit www.aboutcookies.org, which contains comprehensive information on how to do this on a wide variety of desktop browsers.
5. What are Internet tags and how do we use them with cookies?
Occasionally, we may use internet tags (also known as action tags, single-pixel GIFs, clear GIFs, invisible GIFs and 1-by-1 GIFs) at this site and may deploy these tags/cookies through a third-party advertising partner or a web analytical service partner which may be located and store the respective information (including your IP-address) in a foreign country. These tags/cookies are placed on both online advertisements that bring users to this site and on different pages of this site. We use this technology to measure the visitors' responses to our sites and the effectiveness of our advertising campaigns (including how many times a page is opened and which information is consulted) as well as to evaluate your use of this website. The third-party partner or the web analytical service partner may be able to collect data about visitors to our and other sites because of these internet tags/cookies, may compose reports regarding the website’s activity for us and may provide further services which are related to the use of the website and the internet. They may provide such information to other parties if there is a legal requirement that they do so, or if they hire the other parties to process information on their behalf.
If you would like more information about web tags and cookies associated with on-line advertising or to opt-out of third-party collection of this information, please visit the Network Advertising Initiative website http://www.networkadvertising.org.
6. Analytics and Advertisement Cookies
We use third-party cookies (such as Google Analytics) to track visitors on our website, to get reports about how visitors use the website and to inform, optimize and serve ads based on someone's past visits to our website.
You may opt-out of Google Analytics cookies by the websites provided by Google:
https://tools.google.com/dlpage/gaoptout?hl=en
As provided in this Privacy Policy (Article 5), you can learn more about opt-out cookies by the website provided by Network Advertising Initiative:
http://www.networkadvertising.org
We inform you that in such case you will not be able to wholly use all functions of our website.
Close